-
칼 자이스(Carl Zeiss)의 역사와 EUV 리소그래피 광학 (25.9.3)TechStock&Review/SemiConduct 2025. 9. 3. 08:33
칼 자이스(Carl Zeiss)의 역사와 EUV 리소그래피 광학
Executive Summary
본 보고서는 19세기 독일의 작은 광학 작업장에서 출발하여 오늘날 최첨단 반도체 산업의 핵심 기술을 유일하게 공급하는 글로벌 리더로 성장한 칼 자이스(Carl Zeiss)의 175년이 넘는 역사를 심층적으로 분석한다. 자이스의 여정은 과학적 엄밀함과 정밀 공학에 뿌리를 두고 있으며, 이는 극자외선(Extreme Ultraviolet, EUV) 리소그래피 광학계라는 현대 기술의 정점을 구현하는 데 결정적인 역할을 했다. 보고서는 물리학자 에른스트 아베와의 협력을 통해 과학 기반 제조의 기틀을 마련한 창업 초기부터, 두 차례의 세계대전과 독일 분단이라는 역사적 격동을 이겨낸 과정, 그리고 네덜란드의 ASML과의 전략적 파트너십을 통해 원자 단위의 정밀도를 요구하는 EUV 광학계를 완성하기까지의 과정을 추적한다. 이를 통해 자이스의 역사적 유산이 어떻게 21세기 디지털 혁명을 가능하게 하는 가장 정교한 제조 기술의 독점적 공급자로 이어졌는지를 종합적으로 조명한다.

제1장: 자이스의 유산: 정밀성과 과학적 엄밀함의 토대
1.1. 창세기: 칼 자이스와 예나 작업장 (1846-1866)
칼 자이스의 역사는 1846년, 독일 튀링겐 주의 작은 대학 도시 예나(Jena)에서 시작되었다. 창업자 칼 자이스(Carl Zeiss)는 정밀 역학 및 광학 기기 작업장을 열고 사업을 시작했다. 그의 초기 사업은 현미경 제작에 집중되었으며, 이는 곧 뛰어난 품질로 명성을 얻기 시작했다. 1847년, 그는 더 큰 규모의 작업장으로 이전하고 첫 번째 견습생을 고용했으며, 그해 9월 첫 번째 복합 현미경을 완성했다.
초기 현미경은 당시의 다른 제품들과 마찬가지로 경험과 시행착오에 의존하여 제작되었다. 그럼에도 불구하고 자이스의 제품은 높은 정밀도로 유럽 과학계에서 빠르게 인정받았다. 사업은 꾸준히 성장하여 1861년에는 약 20명의 직원을 둔 회사로 발전했으며, 튀링겐 산업 박람회에서 금메달을 수상하는 영예를 안았다. 1866년까지 자이스는 1,000번째 현미경을 판매하며 정밀 광학 분야에서 확고한 입지를 다졌다. 이 시기는 자이스가 품질과 정밀성을 최우선으로 하는 기업 철학의 기틀을 마련한 중요한 시기였다.1.2. 과학 혁명: 에른스트 아베와 오토 쇼트와의 협력
자이스의 역사에서 가장 결정적인 전환점은 1866년, 예나 대학의 물리학자 에른스트 아베(Ernst Abbe)와의 협력이 시작되면서 찾아왔다. 칼 자이스는 기존의 장인적 방식의 한계를 인식하고, 현미경의 성능을 과학적 원리에 기반하여 예측하고 설계할 수 있는 방법을 모색했다. 아베는 이러한 요청에 응하여 렌즈 설계를 정밀한 수학적 계산에 기반한 과학의 영역으로 끌어올렸다.
이 협력은 단순히 제품의 성능을 개선하는 것을 넘어, 자이스의 기업 문화 자체를 근본적으로 바꾸어 놓았다. "이론 없는 설계 없고, 측정 없는 제조 없다"는 원칙이 확립된 것이다. 아베의 기여는 현미경에 그치지 않았고, 그는 1877년 회사의 파트너가 되어 회사 경영 전반에 과학적 사고방식을 심었다. 이 과학 우선주의 접근 방식은 당시 산업계에서는 혁명적인 것이었으며, 자이스가 기술적 우위를 점하는 근간이 되었다.
이후 아베는 자신의 이론을 완벽하게 구현할 수 있는 새로운 광학 유리의 필요성을 절감했고, 화학자 오토 쇼트(Otto Schott)를 영입했다. 자이스-아베-쇼트 세 사람의 협력은 광학 기술의 발전에 필수적인 새로운 유리 소재의 개발로 이어졌고, 이는 자이스가 세계 최고의 광학 기업으로 도약하는 발판이 되었다.1.3. 칼 자이스 재단: 독특한 기업 및 사회 구조
1888년 칼 자이스가 세상을 떠난 후, 에른스트 아베는 회사의 미래를 보장하고 자신의 사회적 이상을 실현하기 위해 1889년 칼 자이스 재단(Carl Zeiss Foundation)을 설립했다. 이 재단은 회사의 유일한 소유주가 되었으며, 이는 자이스를 일반적인 주식회사와는 근본적으로 다른 구조로 만들었다.
재단의 정관은 매우 독특했다. 회사의 이익은 단기적인 주주 이익을 위해 사용되는 대신, 과학 연구 지원, 사회 및 문화 프로젝트, 그리고 직원들의 복지 향상에 재투자되도록 규정되었다. 이러한 구조는 자이스가 단기적인 시장 압력에서 벗어나 장기적인 관점에서 대규모의 고위험 연구개발에 투자할 수 있는 환경을 조성했다. 수십 년의 시간과 막대한 자본이 요구되었던 EUV 광학 기술 개발은 이러한 재단의 철학이 없었다면 불가능했을지도 모른다.1.4. 격동의 세기를 항해하다: 세계대전, 독일 분단, 그리고 재통일
자이스의 역사는 20세기 독일의 격동적인 역사와 그 궤를 같이한다. 제1차 세계대전 중에는 군사용 쌍안경과 거리 측정기 등 군수품을 생산했으며, 나치 정권 하에서는 정밀 기기를 제작하여 무기 시스템에 통합했다. 이 시기에는 강제 노동이 동원되기도 했다.
제2차 세계대전의 패전과 함께 자이스는 가장 큰 시련을 맞았다. 예나를 점령한 미군은 소련군이 진주하기 전, 회사의 핵심 과학자와 기술자, 그리고 설계도 등 지적 자산을 서독의 오버코헨(Oberkochen)으로 이전시켰다.
이로 인해 자이스는 동독의 국영기업 'VEB Carl Zeiss Jena'와 서독의 'Carl Zeiss AG'로 분단되었다. 냉전 기간 동안 두 회사는 '자이스'라는 상표권을 두고 전 세계에서 치열한 경쟁과 법적 분쟁을 벌였다.
1991년 독일 통일은 자이스에게 또 다른 전환점이 되었다. 동서독의 자이스는 길고 어려운 과정을 거쳐 재통합되었다. 이 과정은 단순한 기업 합병을 넘어, 반세기 동안 나뉘어 발전해 온 두 조직의 기술력과 지적 자본이 합쳐지는 전략적 통합이었다. 이 재통합된 역량은 1990년대 중반부터 본격화된 EUV 리소그래피라는 거대한 기술적 도전에 맞설 수 있는 규모와 전문성의 토대를 마련해주었다.1.5. 광학 분야의 글로벌 리더: 디지털 시대로의 다각화와 현대화
재통일 이후 자이스는 현미경을 넘어 다양한 광학 분야로 사업을 확장하며 글로벌 리더로서의 입지를 굳혔다. 카메라 렌즈 분야에서는 1960년대 NASA의 아폴로 계획에 참여하여 달 착륙이라는 인류의 위대한 순간을 기록하는 데 기여했으며, 이 경험은 훗날 리소그래피 광학 기술의 기초가 되었다. 이외에도 의료 기술, 산업 측정, 안경 렌즈 등 다양한 분야에서 혁신을 이끌었다.
특히 주목할 점은 반도체 산업으로의 진출이다. 자이스는 일찍부터 반도체 칩 제조의 핵심 공정인 리소그래피에 필요한 '리소그래피 광학(lithography optics)'과 '포토마스크(photomasks)'를 주요 사업 분야로 발전시켰다. 이는 자이스가 축적해 온 정밀 광학 기술이 21세기 디지털 시대를 여는 가장 중요한 기술과 접목되는 순간이었다.연도 주요 사건 의의 1846 칼 자이스, 예나에 정밀 광학 작업장 설립 과학 기반 정밀 광학 기업의 시작 1866 물리학자 에른스트 아베와의 협력 시작 경험 기반 제작에서 과학적 원리 기반 설계로의 전환 1889 에른스트 아베, 칼 자이스 재단 설립 장기적 연구개발을 중시하는 독특한 기업 지배구조 확립 1945 제2차 세계대전 후 동서독 회사로 분단 냉전 시대 동안 두 개의 자이스로 나뉘어 경쟁 및 발전 1960s NASA 아폴로 계획 파트너십 극한 환경에서의 광학 기술력을 입증하고 리소그래피 기술의 기반 마련 ~1980s 리소그래피 광학 사업 진출 반도체 산업의 핵심 공급망으로 진입 시작 1991 동서독 자이스 재통일 분산되었던 기술력과 인적 자원을 통합하여 대규모 R&D 역량 확보 2012 최초의 양산형 EUV 광학 시스템 ASML에 공급 수십 년간의 연구개발이 결실을 맺으며 EUV 시대 개막 제2장: 나노 스케일을 향한 여정: 광학 리소그래피의 역사
2.1. 포토리소그래피의 원리: 빛으로 회로를 '인쇄'하다
반도체 칩 제조의 핵심은 포토리소그래피(photolithography) 공정이다. 이 기술은 흔히 슬라이드 프로젝터에 비유된다. 회로 패턴이 새겨진 마스크(레티클)에 빛을 통과시켜, 빛에 민감하게 반응하는 감광액(photoresist)이 도포된 실리콘 웨이퍼 위에 축소된 회로 이미지를 형성하는 원리다. 이후 노광된 부분 또는 노광되지 않은 부분을 화학적으로 제거(식각)하고, 빈 공간을 전도성 물질로 채우는 과정을 수십에서 최대 100회까지 반복하여 복잡한 3차원 구조의 집적 회로를 완성한다.
2.2. 파장 경쟁: G-라인에서 심자외선(DUV)까지
리소그래피 기술의 역사는 더 미세한 회로를 그리기 위한 '파장 경쟁'의 역사였다. 빛의 회절 현상 때문에, 빛의 파장(λ)이 짧을수록, 그리고 렌즈의 집광 능력(개구수, Numerical Aperture, NA)이 클수록 더 작은 패턴을 형성할 수 있다 (레일리 기준, Resolution∝λ/NA).
초기 리소그래피는 수은 램프에서 나오는 특정 파장의 빛을 사용했다. G-라인(436 nm)을 시작으로 I-라인(365 nm)으로 발전했으며, 1980년대 후반부터는 엑시머 레이저를 광원으로 사용하는 심자외선(Deep Ultraviolet, DUV) 시대가 열렸다.8 DUV 기술은 불화크립톤(KrF, 248 nm) 레이저를 거쳐 불화아르곤(ArF, 193 nm) 레이저로 발전했다. 2000년대 초, ASML은 193 nm 파장을 사용하되 렌즈와 웨이퍼 사이를 물로 채워 빛의 굴절률을 높임으로써 실효 파장을 단축시키는 '이머전(immersion) 리소그래피' 기술을 개발하여 DUV 기술의 수명을 극적으로 연장시켰다.시대 광원 파장 (λ) 핵심 기술 대표 해상도/노드 1980s 수은 램프 (G-Line) 436 nm Projection > 500 nm 1980s-1990s 수은 램프 (I-Line) 365 nm Projection ~ 350 nm 1990s-2000s 엑시머 레이저 (KrF) 248 nm DUV ~ 130 nm 2000s-2010s 엑시머 레이저 (ArF) 193 nm DUV ~ 65 nm 2010s-현재 엑시머 레이저 (ArF) 193 nm DUV Immersion ~ 7 nm (Multi-patterning) 2019-현재 레이저 생성 플라즈마 (Sn) 13.5 nm EUV 7 nm, 5 nm, 3 nm 2.3. 물리적 한계에 부딪히다: 굴절 광학계의 종말과 패러다임 전환의 필요성
이머전 리소그래피와 여러 번 패턴을 겹쳐 그리는 멀티 패터닝(multi-patterning) 기술 덕분에 반도체 업계는 193 nm DUV 기술로 7 nm 공정까지 구현할 수 있었다. 하지만 이는 공정의 복잡성과 비용을 기하급수적으로 증가시켰다. 근본적으로 193 nm보다 짧은 파장의 빛을 사용하는 새로운 기술이 필요했지만, 이는 거대한 물리적 장벽에 부딪혔다.
193 nm 이하의 파장에서, 특히 100 nm 이하의 극자외선 영역에서는 공기를 포함한 거의 모든 물질이 빛을 강하게 흡수한다. 이는 기존처럼 렌즈를 사용하여 빛을 굴절시켜 초점을 맞추는 '굴절 광학계(refractive optics)'가 더 이상 작동할 수 없음을 의미했다. 렌즈 자체가 빛을 흡수해버리기 때문이다. 따라서 리소그래피 기술이 다음 단계로 나아가기 위해서는 렌즈를 버리고 완전히 새로운 패러다임, 즉 '반사 광학계(reflective optics)'로 전환해야만 했다.2.4. '불가능한' 아이디어의 탄생: 극자외선(EUV)의 여명
EUV 리소그래피, 초기에는 '소프트 엑스선(soft x-ray)' 리소그래피로 불렸던 이 기술의 개념은 1980년대에 처음 등장했다.
일본의 키노시타 히루(Hiroo Kinoshita)는 1980년대 중반, 다층 박막 거울을 이용해 최초로 EUV 이미지를 투영하는 데 성공하며 그 가능성을 열었다. 하지만 당시 학계와 산업계의 반응은 매우 회의적이었다. EUV 빛을 충분한 세기로 안정적으로 만들어내는 광원, 그리고 그 빛을 손실 없이 반사시켜 웨이퍼까지 전달할 초정밀 거울을 제작하는 것은 기술적으로 불가능에 가깝다고 여겨졌다.
수많은 기술적 난제에도 불구하고 연구는 계속되었다. 여러 파장 대역이 검토된 끝에, 최종적으로 13.5 nm가 EUV 리소그래피의 표준 파장으로 채택되었다.
이는 두 가지 핵심 기술의 최적점에서 결정된 것이다. 첫째, 주석(Sn) 플라즈마에서 13.5 nm 파장의 빛을 가장 효율적으로 생성할 수 있었고, 둘째, 몰리브덴(Mo)과 실리콘(Si)을 교대로 쌓은 다층 박막 거울이 바로 이 파장에서 가장 높은 반사율을 보였기 때문이다. 이로써 반도체 산업은 수십 년이 걸릴 '불가능을 향한 도전'의 첫발을 내디뎠다.제3장: 유럽 연합: ASML-자이스 파트너십과 EUV의 산업화
3.1. 파트너십의 구축: 전략적 공생 관계 (1986-현재)
EUV 리소그래피의 상용화는 한 기업의 힘만으로는 불가능한 과제였다. 이 기술의 성공은 네덜란드의 장비 제조업체 ASML과 독일의 광학 전문기업 자이스 간의 깊고 전략적인 파트너십이 있었기에 가능했다. 두 회사의 공식적인 파트너십은 ASML이 필립스(Philips)와 ASMI의 합작 투자로 막 설립된 1984년 직후인 1986년에 시작되었다. 자이스는 ASML이 설립되기 이전인 1983년부터 이미 광학 시스템을 공급하기 시작했다.
이 관계는 단순한 부품 공급업체와 고객의 관계를 초월했다. ASML은 전체 시스템의 아키텍처를 설계하고 각 모듈을 통합하는 '시스템 통합자'의 역할을 맡았고, 자이스는 그 심장부에 해당하는, 누구도 대체할 수 없는 초정밀 광학계를 개발하고 생산하는 역할을 담당했다.
ASML이 초기에 재정적으로 어려움을 겪던 시절부터 시작된 이 협력 관계는 상호 신뢰와 공동의 비전을 바탕으로 수십 년간 이어져 왔다. 이는 단순한 비즈니스 관계가 아닌, 공동의 목표를 향한 기술적 공생 관계였다.3.2. 거대한 도전 과제 극복: 광원, 광학계, 진공의 삼중고
EUV 개발은 수십 년에 걸친 마라톤이었으며, 그 과정에서 극복해야 할 기술적 장벽은 산더미 같았다. 특히 세 가지 핵심 영역에서 근본적인 혁신이 필요했다.
- 광원(Light Source): 안정적이면서도 양산에 필요한 수준의 강력한 13.5 nm 빛을 생성하는 것은 가장 큰 난제 중 하나였다. 수많은 시도 끝에, ASML은 광원 전문 기업 사이머(Cymer)를 인수한 후 '레이저 생성 플라즈마(Laser-Produced Plasma, LPP)' 방식을 완성했다. 이 방식은 진공 챔버 안에서 초당 50,000개의 미세한 주석 방울을 떨어뜨리고, 여기에 강력한 이산화탄소 레이저를 두 번 연속으로 발사하여 주석을 섭씨 220,000도에 달하는 초고온 플라즈마 상태로 만들어 EUV 빛을 방출시키는 극도로 복잡한 기술이다.
- 광학계(Optics): 원자 수준의 정밀도를 가진 비구면 거울들을 제작하고, 이를 나노미터 이하의 오차로 정렬하여 빛의 경로를 제어하는 것은 EUV 기술의 성패를 좌우하는 핵심이었다. 이는 전적으로 자이스의 영역이었다.
- 환경(Environment): EUV 빛은 공기 분자에 의해 쉽게 흡수되므로, 광원에서 웨이퍼에 이르는 빛의 전 경로는 오염 물질이 완벽히 제거된 초고진공(ultra-high vacuum) 상태로 유지되어야 했다.
2025.03.08 - [TechStock&Review/SemiConduct] - 무어의 법칙을 뒷받침하는 작은 별의 폭발 (25.3.8)
무어의 법칙을 뒷받침하는 작은 별의 폭발 (25.3.8)
무어의 법칙을 뒷받침하는 작은 별의 폭발초신성을 설명하는 동일한 공식으로 EUV 리소그래피 장비가 가능해 졌습니다 천문학자 칼 세이건의 말처럼 우리 모두는 별의 재료로 만들어졌습니다.
spedtrder.tistory.com
3.3. 자이스의 결정적 기여: EUV의 '가장 어려운 문제' 해결
EUV 개발 초기, 업계 전문가들은 세 가지 난제 중에서도 특히 광학계 제작이 가장 어렵고 실현 불가능한 과제가 될 것이라고 예측했다. 하지만 자이스는 수십 년간 축적해 온 초정밀 광학 기술과 재료 과학, 그리고 측정 기술을 총동원하여 이 '불가능한' 과제를 해결해냈다.
ASML 관계자에 따르면, 자이스가 요구되는 사양의 EUV 광학계 제작이 기술적으로 가능하다는 것을 입증했을 때, 전체 EUV 프로그램은 진정한 추진력을 얻었다. 자이스가 가장 큰 불확실성이었던 광학계 문제를 해결해 줌으로써, ASML은 또 다른 거대한 난제였던 광원 개발에 역량을 집중할 수 있었다. 즉, 자이스의 성공은 EUV 개발 전체의 리스크를 줄이고 상용화를 향한 길을 닦은 결정적인 기여였다.3.4. EUV 상용화의 주요 이정표
EUV 기술의 상용화는 단기적인 성과가 아닌, 학계, 연구소, 기업, 정부를 아우르는 거대한 R&D 생태계가 수십 년간의 끈질긴 투자와 협력을 통해 이뤄낸 '인내의 결실'이다. 그 주요 연혁은 다음과 같다.
연도 주요 사건 (Milestone) 주요 기관/기업 기술적 성과 1980년대 EUV 리소그래피 초기 개념 연구 시작 일본 NTT, 히타치; 미국 국립연구소 세계 최초 EUV 이미지 구현 1995 유럽 EUV 개발 본격화를 위한 워크숍 개최 Zeiss, Fraunhofer 등 유럽 컨소시엄 결성의 기반 마련 1997-1999 ASML, EUV 연구 시작 및 미국 컨소시엄 참여 ASML, Intel, 미국 에너지부 EUV 연구 본격화 및 글로벌 협력 체계 구축 2000년대 초반 유럽 중심의 R&D 컨소시엄(EUCLIDES) 결성 ASML, Zeiss, IMEC, Fraunhofer 핵심 요소 기술(광원, 광학계, 마스크) 개발 가속화 2009 프로토타입 장비로 세계 최초 22nm SRAM 제작 성공 IMEC, ASML EUV 기술의 반도체 소자 적용 가능성 실증 2010 첫 프로토타입 EUV 장비(NXE:3100) 출하 ASML, 삼성전자 연구 개발용 장비의 첫 상업적 공급 2012 첫 양산형 EUV 광학계(Starlith® 3100) 공식 납품 Zeiss, ASML 양산형 장비 개발의 핵심 부품 확보 2013 첫 양산형 장비(NXE:3300B) 시장 출시 ASML 10nm급 공정 개발을 위한 양산 장비 시대 개막 2019 EUV 기술로 제조된 최초의 상용 제품 출시 삼성전자, TSMC 삼성 갤럭시 노트10 출시, EUV 시대 본격 개막 2023 첫 High-NA EUV 장비(EXE:5000) 출하 ASML, Intel 2nm 이하 옹스트롬 시대를 위한 차세대 장비 공급 시작
3.5. 유대감의 심화: ASML의 칼 자이스 SMT 전략적 투자
EUV 기술이 상용화된 이후에도 기술 개발은 멈추지 않았다. 다음 세대 기술인 High-NA EUV 시스템 개발에는 이전과는 비교할 수 없는 막대한 규모의 연구개발비와 설비 투자가 필요했다. 이러한 재정적 부담을 분담하고 미래 기술 개발을 가속화하기 위해, ASML은 2016년 매우 중요한 전략적 결정을 내렸다.
ASML은 약 10억 유로를 투자하여 자이스의 반도체 사업부인 칼 자이스 SMT(Carl Zeiss SMT)의 지분 24.9%를 인수했다. 또한 향후 6년간 High-NA 광학계 개발을 위해 약 7억 6천만 유로의 R&D 및 설비 투자를 지원하기로 합의했다. 이 투자는 ASML이 자이스를 단순한 파트너가 아닌, 미래를 함께 개척해야 할 운명 공동체로 인식하고 있음을 명확히 보여주는 상징적인 사건이었다. 이는 두 회사의 공생 관계를 더욱 공고히 하고, 차세대 EUV 기술 개발에 대한 공동의 위험과 이익을 공유하는 구조를 만들었다.제4장: 장비의 심장: 자이스 EUV 광학 시스템
4.1. 시스템 아키텍처: 조명 및 투영 광학계를 통과하는 빛의 여정
ASML의 EUV 장비 내에서 빛이 이동하는 경로는 크게 두 부분으로 나뉜다: 조명 시스템(Illumination System)과 투영 광학계(Projection Optics)이다.
- 조명 시스템: 이 시스템의 역할은 플라즈마 광원에서 방출된 EUV 빛을 수집(collect)하고, 불필요한 파장의 빛이나 이물질을 걸러낸 후, 빛의 형태를 균일하게 만들어 레티클(마스크)을 고르게 비추는 것이다. 거대한 집광 거울(collector mirror)을 포함한 여러 개의 거울로 구성된다.
- 투영 광학계: 조명 시스템을 통과한 빛이 레티클에 새겨진 회로 패턴을 반사하면, 투영 광학계가 이 빛을 받아 웨이퍼 위로 전달한다. 이 과정에서 이미지는 통상 4배로 축소된다. 현재 주력인 0.33 NA 시스템은 6개의 고도로 정밀한 비구면 거울로 구성되어 있으며, 이 거울들이 빛의 경로를 제어하여 웨이퍼 위에 정확한 회로 이미지를 형성한다.

EUV 장비 내 광학계 디자인 
4.2. 반사의 물리학: 13.5 nm 파장에서 거울이 필수적인 이유
앞서 언급했듯이, 13.5 nm 파장의 EUV 빛은 거의 모든 물질에 의해 강력하게 흡수된다. 물질의 굴절률이 1에 매우 가까워 렌즈를 이용한 빛의 굴절이 거의 일어나지 않을 뿐만 아니라, 렌즈를 통과하는 동안 빛 에너지가 대부분 소실된다.
이러한 물리적 특성 때문에 EUV 리소그래피는 빛을 투과시키는 렌즈 대신, 빛을 반사시키는 거울을 사용하는 '전반사(all-reflective)' 시스템을 채택할 수밖에 없다. 또한 빛이 공기 분자와 충돌하여 흡수되는 것을 막기 위해, 광원에서부터 웨이퍼까지 빛이 지나가는 모든 경로는 초고진공 상태로 유지되어야 한다.
4.3. 브래그 반사기: 13.5 nm 반사를 위한 Mo/Si 다층 박막의 과학
EUV 거울이 높은 반사율을 가질 수 있는 이유는 '브래그 반사기(Bragg Reflector)' 원리 덕분이다. 이는 굴절률이 다른 두 종류의 얇은 막을 교대로 수십 겹 쌓아 올린 구조이다. 각 층의 경계면에서 반사된 빛들이 서로 보강 간섭(constructive interference)을 일으키도록 층의 두께를 정밀하게 제어하면, 특정 파장의 빛에 대해 매우 높은 반사율을 얻을 수 있다.

13.5 nm 파장의 EUV 빛에 대해서는 몰리브덴(Mo)과 실리콘(Si)이 가장 이상적인 재료 조합으로 밝혀졌다. Mo/Si 다층 박막은 통상 40~50개의 이중층(bilayer)으로 구성되며, 각 이중층의 주기(period)는 굴절률을 보정한 빛 파장의 절반에 해당하는 약 6.9 nm이다. 이 주기는 대략 2.8 nm 두께의 Mo 층과 4.1 nm 두께의 Si 층으로 이루어진다. 이렇게 제작된 거울은 이론적으로 최대 70~75%의 반사율을 달성할 수 있다.제 5 장: 원자를 깎고 쌓아 만드는 궁극의 거울 - Zeiss 다층막 반사경 제조 기술
'세계에서 가장 평탄한 표면'으로 일컬어지는 Zeiss의 EUV 반사경은 현대 과학 기술이 도달할 수 있는 정밀도의 극한을 보여준다. 만약 이 거울을 독일 영토 크기로 확대한다면, 가장 높은 지점과 낮은 지점의 차이가 1mm 미만에 불과할 정도이다. 이러한 경이로운 정밀도는 원자를 하나씩 쌓고 깎아내는 고도로 통제된 공정을 통해서만 구현될 수 있다.
5.1. 완벽한 시작: 초저열팽창 기판의 제작
EUV 반사경 제조의 첫 단계는 완벽한 기반, 즉 기판(substrate)을 만드는 것에서 시작된다. EUV 노광장치 내부에서 광학계는 강력한 EUV 광원과 고속으로 움직이는 스테이지로 인해 막대한 열 부하(heat load)에 노출된다. 만약 일반적인 소재로 거울을 만든다면 미세한 열팽창만으로도 나노미터 단위의 정밀도가 틀어져 전체 광학계가 왜곡될 것이다. 이를 방지하기 위해, 열팽창 계수가 거의 '0'에 가까운 특수 유리-세라믹 소재(예: Zerodur®)가 기판으로 사용된다.
기판 제조는 거시적인 형태를 잡는 기계적 가공부터 시작된다. 먼저 연삭(Grinding) 공정을 통해 기판을 수 밀리미터의 정밀도로 원하는 비구면(aspheric) 형태로 깎아낸다. 이후 래핑(Lapping) 단계를 거치며 표면을 더욱 매끄럽게 다듬고, 최종적으로 연마(Polishing) 공정을 통해 표면의 미세 거칠기(microroughness)를 원자 수준으로 낮춘다.
이 과정은 단순히 표면을 매끄럽게 만드는 것을 넘어, 후속 다층막 증착 공정의 품질을 좌우하는 기반을 마련하는 핵심 단계이다. 이 단계에서 이미 서브 나노미터(<1 nm) 수준의 표면 형상 정밀도가 요구되며, 이는 이후의 모든 공정이 이룩해야 할 정밀도의 시작점이 된다.
5.2. 빛을 반사하는 인공 결정: Mo/Si 다층막 증착
13.5nm 파장의 EUV 빛을 효율적으로 반사할 수 있는 단일 물질은 자연계에 존재하지 않는다. 이 근본적인 문제를 해결하기 위해 Zeiss는 X선 결정학의 브래그 반사(Bragg reflection) 원리를 나노 공학적으로 응용했다. 브래그 반사는 서로 다른 굴절률을 가진 두 물질의 박막을 교대로 주기적으로 쌓아 올렸을 때, 각 층의 경계면에서 반사된 미약한 빛들이 특정 조건(파장과 입사각)에서 모두 같은 위상으로 중첩되어 강력한 반사광을 만들어내는 보강 간섭(constructive interference) 현상을 이용한다.
EUV 파장대에서는 몰리브덴(Molybdenum, Mo)이 고굴절률 물질로, 실리콘(Silicon, Si)이 저굴절률 물질로 최적의 조합을 이룬다. 이 두 물질을 약 6.9nm 두께(Mo 약 2.8nm, Si 약 4.1nm)의 한 쌍으로 하여, 총 40~50쌍, 즉 80~100개의 층을 기판 위에 증착한다.

유리 Substrate 위에 Mo / Si 격자 구조를 증착시켜 쌓아 올린다. 두깨는 2.8nm , 4.1nm 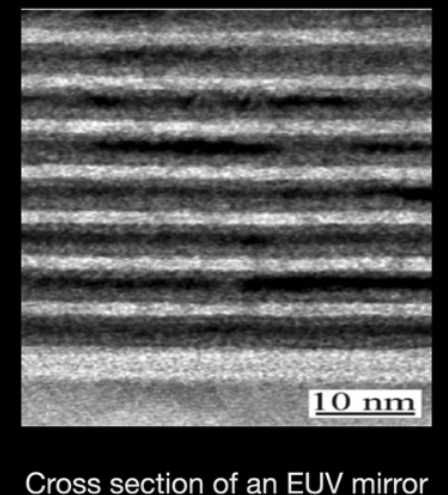
EUV 반사거울 단면도
이렇게 만들어진 다층막 구조는 특정 파장의 빛에만 선택적으로 반응하도록 설계된 '인공 결정(Artificial Crystal)'과 같다. 이는 단순한 표면 코팅 기술을 넘어, 원하는 광학적 특성을 구현하기 위해 원자층을 정밀하게 배열하여 새로운 광학 물질을 창조하는 '나노 스케일 결정 공학(Nano-scale Crystal Engineering)'의 영역에 해당한다. 이 인공 결정 구조 덕분에 EUV 반사경은 13.5nm 파장의 빛에 대해 약 65~70%의 높은 반사율을 달성할 수 있다.
증착 공정에는 주로 마그네트론 스퍼터링(Magnetron Sputtering) 방식이 사용된다. 초고진공 챔버 내에서 Mo와 Si가 각각 코팅된 타겟(target)에 강력한 플라즈마를 발생시켜 타겟 표면의 원자들을 튀어나오게 하고, 회전하는 기판 위에 균일하게 쌓는 방식이다.

Magnet Sputter Deposer 도식도
이때, 각 물질의 증착을 정밀하게 제어하기 위해 타겟 앞에 위치한 셔터(shutter)를 번갈아 열고 닫으며 Mo층과 Si층을 교대로 쌓아 올린다. 각 층의 두께 오차는 피코미터(pm) 단위로 관리되어야 하므로, 공정 전반에 걸쳐 극도의 안정성과 재현성이 요구된다.
5.3. 피코미터(pm) 단위의 정밀도를 향한 여정: 이온빔 가공(IBF)과 초정밀 계측
다층막 증착 공정을 마친 반사경 표면은 인간의 눈으로는 완벽하게 보이지만, 나노미터 세계에서는 여전히 목표 형상 대비 미세한 오차를 가지고 있다. EUV 노광장치의 투영 광학계는 통상 6개의 반사경으로 구성되는데, 전체 광학계의 파면 수차(Wavefront Error, WFE)를 최소화하기 위해 각 개별 반사경에 허용되는 형상 오차(Figure Error, FE)는 FE=WFE/(2⋅n) (여기서 n은 반사경의 수)에 따라 결정된다.
6개 반사경(n=6) 시스템의 경우, 각 거울에 허용되는 형상 오차는 0.19nm RMS(Root Mean Square) 수준으로, 이는 실리콘 원자(직경 약 210pm 또는 0.21nm) 하나의 크기보다도 작은 오차 범위이다.
이처럼 상상조차 어려운 피코미터 단위의 오차를 보정하기 위해 이온빔 가공(Ion Beam Figuring, IBF)이라는 비접촉식 초정밀 가공 기술이 사용된다. IBF는 진공 챔버 내에서 아르곤(Ar)과 같은 비활성 기체의 이온을 가속시켜 만든 빔을 거울 표면에 정밀하게 조사하여, 원자 단위로 물질을 깎아내는 기술이다.
이온 빔의 에너지와 조사 시간을 컴퓨터로 정밀하게 제어함으로써, 오차가 있는 부분만 선택적으로 원자층 단위로 제거할 수 있다.
그러나 IBF 기술의 핵심은 단순히 원자를 깎는 능력에 있는 것이 아니다. 진정한 경쟁력은 '얼마나 정밀하게 측정하고, 그 측정값을 바탕으로 얼마나 정확하게 보정하는가'에 있다. 즉, '측정하고 보정하는 순환 과정(Metrology-Correction Loop)'의 완성도가 기술의 성패를 좌우한다. 이 과정은 다음과 같은 폐쇄 루프(Closed-loop) 방식으로 수없이 반복된다.- 초정밀 계측(Metrology): 먼저, 특수 설계된 초정밀 간섭계(Interferometer)를 사용하여 거울 전체 표면의 형상을 피코미터 수준의 정밀도로 측정한다. 이 측정 과정 자체가 거대한 기술적 도전이며, Zeiss는 이를 위해 거대한 진공 챔버 내에 계측 시스템을 구축했다.
- 오차 분석 및 가공 계획 수립: 측정된 데이터는 이상적인 비구면 형상 데이터와 비교되어 '오차 맵(error map)'을 생성한다. 컴퓨터는 이 오차 맵을 기반으로 어느 위치를 얼마나 깎아내야 하는지에 대한 상세한 IBF 가공 계획을 수립한다.
- 이온빔 가공(IBF): 수립된 계획에 따라 이온 빔이 거울 표면을 스캔하며 오차가 있는 부분만을 선택적으로 깎아낸다.
- 검증 및 반복: 가공이 끝나면 다시 1번의 계측 단계로 돌아가 보정 결과를 확인하고, 목표 정밀도에 도달할 때까지 이 순환 과정을 반복한다.
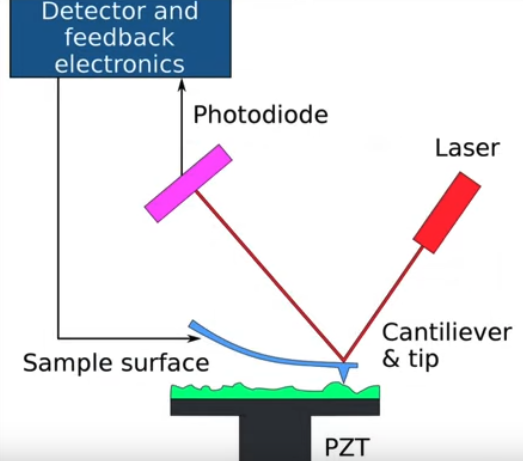
AFM 과 같은 방식으로 표면의 굴곡을 측정하기 때문에 매우 시간이 오래 걸리지만 정밀도는 매우 높다
결론적으로, Zeiss의 독보적인 기술력은 IBF 장비 자체에만 있는 것이 아니라, 거대한 비구면 거울의 형상을 원자 수준으로 측정하고, 그 데이터를 즉시 가공 파라미터로 변환하여 오차를 수정하는 완벽한 '측정-보정 피드백 시스템'을 구축한 데 있다. 이 시스템의 효율성과 정확도가 수개월에 달하는 반사경 제작 기간과 최종 품질을 결정하는 핵심 요소이다.
5.3.1. 최종 검증을 위한 작동 파장 간섭계
완성된 광학 시스템의 전체 파면 오차를 가장 정확하게 측정하는 방법은 실제 작동 환경과 동일한 13.5 nm 파장의 EUV 빛을 사용하는 '작동 파장 간섭계(at-wavelength interferometer)'이다. 이 분야에서는 '위상 변이 점 회절 간섭계(Phase-Shifting Point Diffraction Interferometer, PS/PDI)'와 '횡전단 간섭계(Lateral Shearing Interferometer, LSI)'와 같은 기술이 사용된다.
이 간섭계들은 테스트할 광학계를 통과한 빛의 파면과, 핀홀을 통과시켜 만든 완벽한 구면파 기준 파면을 중첩시켜 그 차이를 측정함으로써, 0.1 nm (100 pm) 이하의 정확도로 파면 오차를 측정할 수 있다.5.3.2. 보조 특성 분석 기술
최종 시스템 검증 외에도, 거울 기판 가공 및 박막 증착의 각 단계에서 다양한 계측 기술이 사용된다.
- EUV 반사율 측정기(EUV Reflectometry): 증착된 다층 박막이 목표 파장에서 원하는 반사율을 갖는지 측정한다.
- 원자간력 현미경(Atomic Force Microscopy, AFM): 거울 표면의 미세 거칠기(roughness)를 원자 단위에서 측정한다.
- X선 회절 분석기(X-ray Diffraction, XRD): 다층 박막의 주기와 각 층의 두께, 결정 구조 등을 분석한다.
이러한 계측 기술들의 융합은 EUV 거울이라는 현대 공학의 기적을 가능하게 한 숨은 공로자이다. 제조 공정 자체가 고에너지 물리 실험과 구별하기 어려울 정도로 정교해졌으며, 생산 현장은 사실상 거대한 물리 실험실이 되었다.
5.4. 보호와 성능 유지를 위한 마지막 단계: 캐핑층(Capping Layer)과 오염 제어
IBF 공정까지 마친 Mo/Si 다층막은 외부 환경에 매우 취약하다. 특히, EUV 노광장치 내부의 혹독한 플라즈마 환경에 노출되면 표면이 손상되거나 오염되어 반사율이 급격히 저하될 수 있다. 이를 방지하고 다층막을 보호하기 위해 표면에 수 나노미터 두께의 얇은 보호막인 캐핑층(Capping Layer)을 증착한다. 캐핑층의 소재로는 내화학성이 뛰어나고 EUV 파장에 대한 흡수가 적은 루테늄(Ruthenium, Ru)이 주로 사용된다.
하지만 IBF 공정으로 인해 다층막 표면의 일부 Si층이 깎여나가고 Mo층이 노출될 수 있다. 여기에 Ru 캐핑층을 바로 증착하면, Ru과 Mo의 광학적 특성이 유사하여 반사 파면의 위상이 변하고 반사율이 불균일해지는 심각한 문제가 발생한다.
이 문제를 해결하기 위해 Zeiss는 매우 정교한 공정을 개발했다. IBF로 깎여나간 영역에 먼저 Si 또는 Si 화합물로 구성된 중간층(intermediate layer)을 증착하여 노출된 Mo층을 덮고 표면을 다시 평탄하게 만든다. 이 중간층의 두께는 IBF로 제거된 두께와 거의 동일하게 정밀 제어된다. 그 후, 평탄화된 중간층 위에 균일한 두께의 Ru 캐핑층을 증착한다.
이 고도의 공정을 통해 반사경의 광학적 성능 저하 없이 표면을 완벽하게 보호할 수 있게 된다.
https://youtu.be/V__HbVlnICc?list=TLGGJtaGCgahSuUwMjA5MjAyNQ제 6 장: 빛의 경로를 설계하다 - EUV 광학계의 구조와 진화
개별적으로 제작된 초정밀 반사경들은 하나의 거대한 광학 시스템으로 통합되어 13.5nm 빛의 경로를 나노미터 이하의 정밀도로 제어하는 역할을 수행한다. 이 광학계는 EUV 노광장치의 성능을 결정하는 심장부이며, 그 설계와 진화 과정에는 수많은 물리적, 공학적 난관을 극복한 혁신이 담겨 있다.
6.1. Zeiss Starlith 광학계의 구조
ASML의 EUV 노광장치에 탑재되는 Zeiss의 광학계(제품명 Starlith®)는 기능적으로 크게 두 부분으로 나뉜다.
첫째는 광원(source)에서 나온 EUV 빛을 균일한 강도와 원하는 각도 분포로 만들어 마스크(reticle)에 비추는 조명계(Illuminator)이다.
둘째는 마스크의 회로 패턴에 의해 반사된 빛을 받아들여 4배 또는 그 이상으로 축소하여 웨이퍼 위의 감광액(photoresist)에 정확히 결상시키는 투영계(Projection Optics)이다.

이 광학계들은 기존의 렌즈 대신 6개 이상의 거대한 비구면(aspheric) 반사경으로 구성된다.
빛이 거울에 수직으로 입사하면 광경로가 막히기 때문에, 모든 거울은 광축에서 벗어난 형태로 설계된 비축(off-axis) 반사경이다. 이러한 비축 비구면 광학계는 설계와 제작, 그리고 정렬이 극도로 복잡하며, 구면 수차, 코마 수차, 비점 수차 등 다양한 종류의 광학 수차(optical aberration)를 보정하는 것이 핵심 과제가 된다.
수십억 개의 트랜지스터로 구성된 복잡한 회로 패턴을 웨이퍼 전체 영역에 걸쳐 단 하나의 왜곡도 없이 전사하기 위해, 이 거울들은 개별적으로 정밀하게 제어된다. 그 정밀도는 지구에서 달 표면에 있는 20mm 크기의 물체를 정확히 조준할 수 있는 수준에 비견된다.
6.2. 해상도의 핵심 지표: 개구수(NA)의 발전
리소그래피 장비의 해상도(resolution), 즉 얼마나 미세한 패턴을 그릴 수 있는지를 결정하는 가장 중요한 물리적 변수는 빛의 파장(λ)과 광학계의 개구수(Numerical Aperture, NA)이다. 최소 선폭(Critical Dimension, CD / θ)은 레일리 방정식(Rayleigh criterion)에 따라 θ = k * λ / NA 로 표현된다 (여기서 k는 공정 변수).
이 식에서 알 수 있듯, 파장(λ)이 짧을수록, 그리고 개구수(Numerical Aperture / NA)가 클수록 더 작은 패턴을 구현할 수 있다. EUV 기술은 파장을 13.5nm로 획기적으로 줄였고, 그 다음 단계는 NA를 높여 해상도를 극대화하는 것이었다.
현재 반도체 양산의 주력 장비인 ASML의 TWINSCAN NXE 시리즈(NXE:3400, 3600, 3800 등)에는 NA 0.33을 갖는 Zeiss Starlith 광학계가 탑재되어 있다. 이 광학계는 7nm, 5nm를 거쳐 3nm 공정의 양산을 가능하게 하며 EUV 시대를 열었다. 그러나 반도체 스케일링을 2nm 이하의 '옹스트롬(angstrom)' 시대로 이끌기 위해서는 NA 0.33의 한계를 넘어서는 새로운 기술이 필요했다.
이에 ASML과 Zeiss는 수년간의 공동 연구 끝에 NA를 0.55로 대폭 향상시킨 차세대 High-NA 광학계를 개발했다. 하지만 NA를 0.33에서 0.55로 높이는 것은 단순히 거울을 더 크게 만드는 차원의 문제가 아니었다. 이는 광학 설계의 근본적인 패러다임을 바꾸는 '비대칭(Anamorphic) 혁명'을 통해서만 해결 가능한 거대한 도전이었다. 그 과정은 다음과 같다.- 목표 설정: 2nm 이하 노드를 구현하기 위해 해상도를 높여야 한다. 이를 위해 NA를 0.33에서 0.55로 키워야 한다.
- 물리적 장벽 직면: NA를 높이면 투영계의 마지막 거울이 매우 커지고, 이로 인해 빛이 마스크에 입사하는 각도가 기존보다 훨씬 가팔라진다. EUV 마스크는 다층막 구조로 되어 있어 특정 입사각 범위에서만 높은 반사율을 보이는데, 이 각도를 벗어나면 '그림자 효과(shadowing effect)' 등으로 인해 반사율이 급격히 떨어져 패턴을 제대로 웨이퍼에 전달할 수 없게 된다.
- 단순한 해결책의 기각: 이 입사각 문제를 해결하는 가장 간단한 방법은 광학계의 축소율을 기존의 4배에서 8배로 늘리는 것이다. 하지만 이는 마스크에 그려야 할 패턴의 크기가 2배로 커져야 함을 의미하며, 결과적으로 마스크 자체의 크기도 2배로 커져야 한다. 이는 수십 년간 유지되어 온 반도체 마스크 표준 생태계(제작, 검사, 이송 등) 전체를 뒤엎는 것으로, 천문학적인 비용과 시간을 유발하여 현실적으로 불가능한 해결책이었다.
- 창의적 해결책의 채택: Zeiss와 ASML은 이 딜레마를 해결하기 위해 '비대칭(Anamorphic)' 광학계라는 혁신적인 아이디어를 도입했다. 이는 모든 방향으로 동일하게 축소한다는 기존 광학계의 상식을 깨고, x축(수평 방향)으로는 기존과 같이 4배, y축(수직 방향)으로는 8배로 다르게 축소하는 방식이다. y축의 축소율을 8배로 높임으로써 마스크에서의 입사각 문제를 해결하고, 동시에 x축은 4배를 유지하여 기존 마스크 크기와 표준을 그대로 사용할 수 있게 했다.
- 결론: High-NA 기술로의 전환은 물리적 한계와 산업 생태계의 현실적 제약 사이에서 최적의 해답을 찾기 위한 공학적 창의성의 승리였다. 이는 단순히 성능을 업그레이드하는 것을 넘어, 광학 설계의 기본 패러다임을 전환한 기술적 혁명으로 평가받는다.
7. 궁극의 기술 집약체 - ASML EUV 노광장치
Zeiss가 제작한 초정밀 광학계는 ASML의 노광장치에 통합되어 비로소 하나의 완전한 반도체 생산 시스템으로 탄생한다. 10만 개가 넘는 부품과 수십만 줄의 소프트웨어 코드로 구성된 ASML의 EUV 노광장치는 인류가 만든 가장 복잡하고 정밀한 기계 중 하나로, 다양한 첨단 기술 모듈이 유기적으로 결합되어 작동한다.
7.1. 시스템 아키텍처와 핵심 모듈
ASML의 EUV 노광장치(TWINSCAN 시리즈)는 다음과 같은 핵심 모듈로 구성된다.
- 광원 (Light Source): 장치의 가장 아래쪽에 위치하며, 13.5nm의 EUV 빛을 생성하는 역할을 한다. 초당 5만 번의 빈도로, 고출력 이산화탄소(CO2) 레이저를 직경 25 마이크로미터의 미세한 액체 주석(tin, Sn) 방울에 정확히 발사한다. 첫 번째 약한 레이저 펄스가 주석 방울을 팬케이크 모양으로 납작하게 만들고, 이어지는 강력한 메인 펄스가 이를 타격하여 순간적으로 섭씨 22만 도에 달하는 초고온 플라즈마 상태로 만든다. 이 플라즈마에서 13.5nm 파장의 EUV 빛이 방출된다.
- 광학계 (Optical Column): Zeiss가 제작한 다수의 다층막 반사경으로 구성된 조명계와 투영계가 광원에서 나온 빛의 경로를 제어하고, 마스크의 패턴을 축소하여 웨이퍼에 투영한다. 이 모든 광경로는 진공 상태에서 이루어진다.
- 레티클 및 웨이퍼 스테이지 (Reticle & Wafer Stages): 마스크(레티클)와 웨이퍼를 탑재하고, 노광이 진행되는 동안 나노미터 이하의 정밀도로 동기화되어 고속으로 움직이는 초정밀 기계 장치이다. 특히 웨이퍼 스테이지는 초당 2만 번 이상 위치를 확인하고 보정하며, 0.25nm 이하의 위치 결정 정밀도를 자랑한다. 차세대 High-NA 장비의 스테이지는 더욱 경이로운 성능을 보여주는데, 웨이퍼 스테이지는 중력의 8배(8G), 레티클 스테이지는 32G라는 엄청난 가속도로 움직인다. 이는 경주용 자동차가 시속 100km까지 0.09초 만에 도달하는 것과 맞먹는 가속도이다.
- 진공 챔버 (Vacuum Chamber): EUV 빛은 공기를 포함한 거의 모든 기체에 흡수되므로, 광원에서 시작하여 웨이퍼에 도달하기까지 빛이 지나가는 모든 경로는 초고진공 상태로 유지되어야 한다. 이를 위해 거대한 진공 챔버가 시스템 전체를 감싸고 있으며, 정교한 진공 펌프 시스템이 내부 압력을 지속적으로 관리한다.
7.2. 세대를 거듭하는 혁신: TWINSCAN NXE에서 EXE로
ASML의 EUV 장비는 반도체 제조사들의 미세화 요구와 생산성 향상 요구에 부응하기 위해 세대를 거듭하며 끊임없이 진화해왔다.
- TWINSCAN NXE:3400B/C: 7nm와 5nm 공정의 대량 양산 시대를 본격적으로 연 주력 장비이다. 이전 세대 대비 광원 출력을 높이고 시스템 안정성을 개선하여 시간당 웨이퍼 처리량(Wafers Per Hour, WPH)을 125장(B 모델)에서 170장 이상(C 모델)으로 크게 끌어올리며 EUV 기술의 경제성을 확보했다.
- TWINSCAN NXE:3600D: 5nm와 3nm 공정을 주력으로 지원하는 모델로, 이전 NXE:3400C 대비 생산성을 15~20% 향상시키고 오버레이(overlay, 층간 정렬) 정확도를 개선하여 더욱 까다로워진 공정 요구사항에 대응했다.
- TWINSCAN NXE:3800E: 3nm와 2nm 공정을 목표로 개발된 최신 Low-NA 장비이다. 새로운 웨이퍼 스테이지를 도입하여 WPH를 195장 이상(향후 업그레이드를 통해 220장 목표)으로 높였으며, 오버레이 정확도를 1.1nm 이하로 개선하여 EUV 이중 패터닝(double patterning)과 같은 차세대 공정의 요구 조건을 충족시킨다.
- TWINSCAN EXE:5000 (High-NA): NA 0.55 광학계를 탑재하여 8nm의 궁극적인 해상도를 구현, 2nm 이하 '옹스트롬' 시대를 여는 차세대 플랫폼이다. 비대칭 광학계의 특성상 한 번에 노광할 수 있는 면적(exposure field)이 기존의 절반으로 줄어들었지만, 앞서 언급한 초고속 스테이지 기술을 통해 이를 극복하고 NXE 시리즈보다 높은 시간당 185장 이상의 생산성을 목표로 한다.
이러한 기술적 진화 과정은 아래 표와 같이 정리할 수 있다. 이 표는 반도체 제조사들이 더 미세한 회로를 그리면서도(해상도, 오버레이) 경제성(생산성)을 잃지 않도록 ASML이 '정밀도'와 '생산성'이라는 두 가지 목표를 동시에 추구하며 끊임없이 혁신해 온 역사를 명확하게 보여준다.
항목 NXE:3400C NXE:3600D NXE:3800E EXE:5000 개구수 (NA) 0.33 0.33 0.33 0.55 해상도 (Resolution) 13 nm < 13 nm < 13 nm 8 nm 생산성 (WPH) ≥170 (at 20 mJ/cm²) ≥150 (at 30 mJ/cm²) >195 (at 30 mJ/cm²) >185 (목표) 오버레이 정확도 1.5 nm < 1.5 nm < 1.1 nm N/A (개발 중) 주요 적용 노드 7 nm / 5 nm 5 nm / 3 nm 3 nm / 2 nm < 2 nm 광학계 특징 등방성 4x 축소 등방성 4x 축소 등방성 4x 축소 비대칭 4x/8x 축소 결론: 역사, 과학, 그리고 공학의 융합
칼 자이스의 역사는 한 세기 반을 아우르는 시간 동안 과학적 엄밀함이라는 단일한 철학이 어떻게 현대 기술의 정점에 도달할 수 있는지를 보여주는 탁월한 사례이다. 에른스트 아베가 확립한 과학 기반의 접근법, 칼 자이스 재단이 보장한 장기적 비전, 그리고 독일 통일로 통합된 기술적 역량은 EUV 광학계라는 전례 없는 도전에 맞설 수 있는 완벽한 토양을 제공했다.
ASML과의 전략적 파트너십은 국경을 초월한 유럽 혁신 모델의 성공 사례로서, 상호 의존적인 공생 관계를 통해 누구도 넘볼 수 없는 기술적 해자를 구축했다. 자이스가 개발한 EUV 광학계, 특히 피코미터 단위의 정밀도로 제어되는 다층 박막 반사경은 단순한 부품이 아니라 21세기 디지털 문명의 근간을 이루는 핵심 기술 그 자체이다.
결론적으로, 자이스는 19세기 현미경 제작의 정밀성에서 출발하여, 20세기의 역사적 격동을 이겨내고, 21세기에는 원자 수준의 빛을 제어하는 기술을 완성했다. 이는 과거의 유산이 어떻게 미래를 창조하는지를 증명하는 것이며, 자이스가 단순한 광학 회사를 넘어 첨단 인공지능, 자율주행, 그리고 미래 의료 기술의 발전을 가능하게 하는, 디지털 시대의 근본적인 가능성을 여는 기업임을 확고히 한다. High-NA EUV 기술의 등장은 이러한 여정이 아직 끝나지 않았음을 시사하며, 자이스는 앞으로도 물리학과 공학의 경계를 허물며 인류의 기술적 지평을 넓혀나갈 것이다.
Works cited
- Zeiss (company) - Wikipedia, https://en.wikipedia.org/wiki/Zeiss_(company)
- History: Journey through the evolution of optics | ZEISS, https://www.zeiss.com/corporate/en/about-zeiss/past/history.html
- Company History - ZEISS, https://www.zeiss.com/meditec-ag/en/about-us/company-history.html
- Carl Zeiss – a biography, https://www.zeiss.com/corporate/en/about-zeiss/past/history/carl-zeiss.html
- CELEBRATING 175 YEARS IN OPTICS - 20/20 Magazine, https://www.2020mag.com/CMSDocuments/2021/11/Zeiss_WhitePaper2021.pdf
- Carl Zeiss - A History Of A Most Respected Name In Optics - Company Seven, http://www.company7.com/zeiss/history.html
- ZEISS celebrates 30 years of EUV lithography optics, https://www.zeiss.com/semiconductor-manufacturing-technology/smt-magazine/30-years-of-euv-lithography-optics.html
- EUV lithography and technology | ZEISS SMT, https://www.zeiss.com/semiconductor-manufacturing-technology/inspiring-technology/euv-lithography.html
- Light of the future: EUV lithography by ZEISS SMT, https://www.zeiss.com/semiconductor-manufacturing-technology/smt-magazine/so-does-euv-lithography-work.html
- EUV lithography and technology from ZEISS SMT, https://www.zeiss.com/semiconductor-manufacturing-technology/smt-magazine/euv-lithography-as-an-european-joint-project.html
- Lenses & mirrors - Lithography principles - ASML, https://www.asml.com/en/technology/lithography-principles/lenses-and-mirrors
- Making EUV: from lab to fab – Stories | ASML, https://www.asml.com/en/news/stories/2022/making-euv-lab-to-fab
- Extreme ultraviolet lithography - Wikipedia, https://en.wikipedia.org/wiki/Extreme_ultraviolet_lithography
- EUV lithography systems – Products - ASML, https://www.asml.com/en/products/euv-lithography-systems
- Adaptation of the reflectance of Bragg mirrors to wide source spectra - EUV Litho, Inc., https://www.euvlitho.com/2019/P57.pdf
- Our history | ASML - Supplying the semiconductor industry, https://www.asml.com/en/company/about-asml/history
- EUV Lithography in Semiconductor Manufacturing | ASML - WIoT Group, https://wiot-group.com/think/en/articles/euv-lithography-in-semiconductor-manufacturing/
- The "Invisible Giant" in Lithography Equipment-Exclusive Interview with Germany's Carl Zeiss Semiconductor | SemiWiki, https://semiwiki.com/forum/threads/the-invisible-giant-in-lithography-equipment-exclusive-interview-with-germanys-carl-zeiss-semiconductor.20747/
- How ZEISS and ASML Enable the Modern Chip Industry, https://hoeijmakers.net/zeiss-and-asml/
- ZEISS and ASML Strengthen Partnership for Next Generation of EUV Lithography, https://www.asml.com/en/news/press-releases/2016/zeiss-and-asml-strengthen-partnership-for-next-generation-of-euv-lithography
- From Science Fiction to Reality - The Evolution of EUV Lithography in Chip Fabrication, https://curiocial.com/evolution-euv-lithography-chip-fabrication/
- How the EUV Mirrors are Made - Asianometry, https://asianometry.passport.online/member/episode/how-the-euv-mirrors-are-made
- Anniversary 50 Years of Semiconductor Manufacturing Technology - ZEISS, https://www.zeiss.com/semiconductor-manufacturing-technology/news-and-events/smt-press-releases/anniversary-50-years-smt.html
- Tracing the Emergence of Extreme Ultraviolet Lithography, https://cset.georgetown.edu/publication/tracing-the-emergence-of-extreme-ultraviolet-lithography/
- High-NA-EUV Lithography: the next EUV generation | ZEISS SMT, https://www.zeiss.com/semiconductor-manufacturing-technology/inspiring-technology/high-na-euv-lithography.html
- EUV Lithography system consisting of six mirrors image the reflective mask onto a wafer. - ResearchGate, https://www.researchgate.net/figure/EUV-Lithography-system-consisting-of-six-mirrors-image-the-reflective-mask-onto-a-wafer_fig1_230859935
- Six-mirror projection system for EUV lithography. - ResearchGate, https://www.researchgate.net/figure/Six-mirror-projection-system-for-EUV-lithography_fig5_44387172
- EUV Lithography in Semiconductor Fabs - Future Bridge Americas, https://future-bridge.us/euv-lithography-in-semiconductor-fabs/
- 5 things you should know about High NA EUV lithography - ASML, https://www.asml.com/en/news/stories/2024/5-things-high-na-euv
- High-NA-EUV lithography: mirroring the future - ZEISS, https://www.zeiss.com/semiconductor-manufacturing-technology/smt-magazine/high-na-euv-lithography.html
- High-NA-EUV lithography: New technology for global microchip production - ZEISS, https://www.zeiss.com/semiconductor-manufacturing-technology/news-and-events/smt-press-releases/2024/high-na-euv-lithography.html
- High-performance EUV multilayer optics - Sci-Hub, https://moscow.sci-hub.st/2133/3a6e0253b8c2ed2d98d2f71c9cb31b2a/kaiser2008.pdf
- Comparative Study on Microstructure of Mo/Si Multilayers Deposited on Large Curved Mirror with and without the Shadow Mask - PMC, https://pmc.ncbi.nlm.nih.gov/articles/PMC10055843/
- Optical considerations of EUVL wavelength, NA, and multilayers at large angles, https://www.spiedigitallibrary.org/conference-proceedings-of-spie/13424/1342402/Optical-considerations-of-EUVL-wavelength-NA-and-multilayers-at-large/10.1117/12.3052669.full
- (PDF) Ion beam sputtering of x-ray multilayer mirrors - ResearchGate, https://www.researchgate.net/publication/228535046_Ion_beam_sputtering_of_x-ray_multilayer_mirrors
- High-performance Mo-Si multilayer coatings for extreme-ultraviolet lithography by ion-beam deposition - Optica Publishing Group, https://opg.optica.org/abstract.cfm?uri=ao-42-19-4049
- Extreme ultraviolet multilayer mirror with near-zero IR reflectance - Optica Publishing Group, https://opg.optica.org/ol/upcoming_pdf.cfm?id=117120
- Challenges and limits to patterning using extreme ultraviolet lithography, https://www.spiedigitallibrary.org/journals/journal-of-micro-nanopatterning-materials-and-metrology/volume-24/issue-01/011005/Challenges-and-limits-to-patterning-using-extreme-ultraviolet-lithography/10.1117/1.JMM.24.1.011005.full
- preprint - OSTI.GOV, https://www.osti.gov/servlets/purl/251217
- EUV Wavefront Measurement of six-mirror optic using EWMS - SPIE Digital Library, https://www.spiedigitallibrary.org/conference-proceedings-of-spie/6921/69212U/EUV-wavefront-measurement-of-six-mirror-optics-using-EWMS/10.1117/12.772624.pdf
- Wavefront measurement interferometry at the operational wavelength of extreme-ultraviolet lithography - Optica Publishing Group, https://opg.optica.org/abstract.cfm?&uri=ao-46-27-6783
- (PDF) EUV interferometry of a four-mirror ring-field EUV optical system - ResearchGate, https://www.researchgate.net/publication/228587095_EUV_interferometry_of_a_four-mirror_ring-field_EUV_optical_system
- Picometer sensitivity metrology for EUV absorber ... - eScholarship, https://escholarship.org/content/qt2p42q3sr/qt2p42q3sr_noSplash_76eacc9b2b2f23ca7a46f336f1bff79b.pdf
반응형'TechStock&Review > SemiConduct' 카테고리의 다른 글
High-NA 판매의 어려움: EUV 멀티패터닝의 관행, Depth of Focus 에 대한 미언급 (25.9.30) (1) 2025.09.30 Huawei Ascend 생산 증가: Die Banks 와 HBM 병목 현상 (25.9.11) (1) 2025.09.11 메모리 장벽의 확장: HBM의 부상과 로드맵 (25.8.14) (12) 2025.08.14 HBM 개발사: AI 시대를 연 메모리 혁명의 전개 과정 (25.7.4) (7) 2025.07.04 NVIDIA 텐서 코어 진화 - Volta 에서 Blackwell 까지 (25.6.26) (5) 2025.06.26